半导体设备销售
回答一下,对半导体感兴趣的可以关注下我 。综合全网观点进行输出,偷摸半小时写写,因为作为业内人士,也很关心这个问题。个人想法在最后,所以请看到最后。
昨天最炸裂的消息来自于华为,中午吃完饭看了一下微信朋友圈,结果发现很多人都在说华为推出Mate60。


那最为关心的华为Mate60的芯片,到底是什么来路?之所以关心,因为这是中国大陆第一块国产7nm+5G芯片。
①囤货论
华为Mate60系列所使用的芯片是2020年9月禁令之前所囤积的产品。假设囤积数量足够且已知Mate40销量较少、Mate50使用高通芯片,因此,或许有足够的芯片供给Mate60[1]。
关于这种可能性推断的信息来源有两个:一个是微博数码博主@我是HYK的照片:照片显示Mate60使用的是Kirin 9000(麒麟9000)芯片,制程为5nm。
另一个则是telecoms网站上一位名叫Scott Bicheno的作者。该作者在2020年10月22日的一篇文章中写道:

因此,如果我们只做简单的加减法数学题的话:如果当年华为囤积的麒麟9000芯片超过1000万枚,考虑到Mate40系列的销量较低,那么应当是有足够芯片供给Mate60的。但现实不是简单的数学题!
②pdf文件泄密论
这种可能性或许有些过于惊悚了——来源于下午在微信群中的一个pdf文件,该文件可能是遭到泄露的内部文件,但也有可能是好事网友的伪造作品。

这份pdf文件中非常明确地表示:Mate60使用了Kirin 9000 Super 5G Soc,且来自于中芯国际7nm全自研工艺。
再比如,在华为官方的英文版论坛上,2022年6月23日发布了一个名为“New Kirin 9000S to power Huawei Mate 50”(新麒麟9000S芯片以驱动华为Mate50)的帖子。”
甚至雪球app上有人说这是华为自己产线造出来的,背后是台积电派了技术指导小组。

③死磕高通论
华为Mate60还是用的高通芯片

这个信息来源是国外的一些网站,不过我个人觉得这些非常不靠谱——因为这些网站对于Mate60性能的估计实在离谱——甚至还有觉得Mate60系列最大存储空间只有512GB的……
④封装论
华为Mate60系列可能使用的是一种使用了3D堆叠技术的芯片,让两块不那么先进的芯片组合在一起,实现“1+1大于2”、比较先进的效果。


理由有两个:
其一是,2022年初,华为年报发布会,当时华为轮值董事长郭平曾表示:华为可以用面积换来性能,采用堆叠工艺,哪怕不那么先进的芯片也可以有竞争力。
其二是,华为的确在芯片堆叠上颇有成绩——20天前,2023年8月9日,华为申请了一项名为“芯片堆叠结构及其形成方法”的专利。
这种可能性的确非常有诱惑力:因为它完美契合了我们的诸多要求:技术上问题不大,自主可控、绕开了台积电和ASML的高端设备也可以实现。
⑤拆机判断论
一些拆机的画面以及主播的讲解透露,华为Mate 60 Pro的CPU上的编号是2035-CN,而台积电的芯片是标注的是TW(产地为我国台湾地区),CN代表的产地是中国大陆,Mate 60 Pro采用的芯片很可能为2020年第35周中芯国际生产。该名主播的直播间最高实时在线20万人,大量网友围观“华为5G回归”的历史性手机拆解过程[2]。


另外,从手机设置菜单的基础信息中也能看到新机芯片型号为麒麟9000s,只是没有更具体的功能描述。

不过目前这都是猜测,这也是关于麒麟9000s芯片身世最神秘的地方,相信这层窗户纸,华为在9月12日的发布会上就会捅破。
⑥3D芯片堆叠介绍
从世界第一款CPU诞生开始到今天,甚至包括摩尔定律本身,都是在二维层面展开的。也就是说,研究重点都放在如何实现单位面积上元器件数量的增加以及微观精度的改进,而3D堆叠的概念是把一块芯片从二维展开至三维,那接下来我们就来了解一下什么叫做3D堆叠。
大家都知道CPU是一个超大规模的集成电路板,指甲盖儿大小的芯片上安置着数以亿计的晶体管,再也留不出任何空白的地方,那为何不再叠加一张纸放在它的上面呢?3D堆叠由此产生。
3D堆叠技术是利用堆叠技术或通过互连和其他微加工技术在芯片或结构的Z轴方向上形成三维集成,信号连接以及晶圆级,芯片级和硅盖封装具有不同的功能。针对包装和可靠性技术的三维堆叠处理技术。该技术用于微系统集成,是在片上系统(SOC)和多芯片模块(MCM)之后开发的先进的系统级封装制造技术[3]。
所谓的3D堆叠技术其实很好理解,就是在原本的封装体里面,封装进两个以上不同功能的芯片,一般都是在不改变原本的封装体积大小,而在垂直方向进行的芯片叠放,这种技术所带来的特点就是改变了原有的在单位面积上不断增加晶体管的方式,而是在垂直方向上进行芯片叠放,自然也会实现芯片的功能多样化。
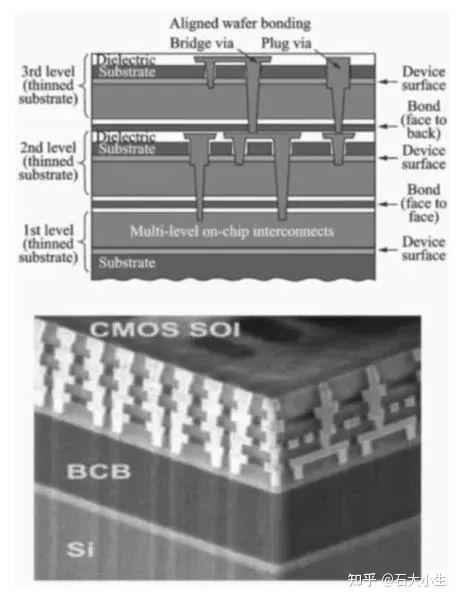
总体上看,3D堆叠技术在集成度、性能、功耗等方面更具优势,同时设计自由度更高,开发时间更短,是各封装技术中最具发展前景的一种。当前,随着高效能运算、人工智能等应用兴起,加上用于提供多个晶圆垂直通信的TSV技术愈来愈成熟,可以看到越来越多的CPU、GPU和存储器开始采用3D堆叠技术。
其他的容我想好再说,谢谢
参考
- ^炸了!上线即售罄的华为Mate60,芯片哪来的? https://mp.weixin.qq.com/s/644_Ttu1K0EiWt-6vkB_yg
- ^历史性时刻,华为搞定全国产5G芯片,Mate 60连夜拆机验证 https://mp.weixin.qq.com/s/pLaa7-wCNyfI2jUILrcf0g
- ^摩尔定律如何继续延续:3D堆叠技术或许是答案 https://mp.weixin.qq.com/s/JSRSiIBdtbUo8lqkJSsHhg